MOSFET ТРАНЗИСТОРЫ ПРОТИВ IGBT
Когда дело доходит до импульсных преобразователей, оба типа транзисторов имеют свои преимущества и недостатки. Но какой из них лучше для данного устройства? В этой статье сравним MOSFET с модулями IGBT чтобы понять, что и где лучше ставить.

Предполагается что в схемах с низким напряжением, низким током, но высокой частотой переключения, предпочтительно использовать полевые транзисторы (MOSFET), а в схемах с высоким напряжением, высоким током, но с низкой частотой – лучше IGBT. Но достаточно ли такой общей классификации? У каждого есть свои дополнительные предпочтения в этом отношении и правда в том, что не существует общего, жесткого стандарта, который позволял бы оценивать параметры данного элемента с точки зрения его использования в импульсных преобразователях. Все зависит от конкретного применения и широкого спектра факторов, таких как частота переключения, размер, стоимость и т. д. Поэтому, вместо того чтобы пытаться решить какой элемент лучше, нужно внимательно изучить различия между этими деталями.
Кратко о MOSFET
MOSFET – это управляемый переключатель с тремя контактами (затвор, сток и исток). Сигнал затвора (управления) подается между затвором и истоком, а контактами переключения являются сток и исток. Сам затвор выполнен из металла и отделен от истока оксидом металла в качестве диэлектрика. Это позволяет снизить энергопотребление и делает этот транзистор отличным выбором для использования в качестве электронного переключателя или усилителя в схеме с общим истоком.
Для правильной работы МОП-транзисторы должны поддерживать положительный температурный коэффициент. Потери во включенном состоянии малы и теоретически сопротивление транзистора в этом состоянии не ограничено – может быть близко к нулю. Кроме того, поскольку МОП-транзисторы могут работать на высоких частотах, они могут работать в устройствах с быстрым переключением и с низкими потерями на переключение.
Существует много различных типов МОП-транзисторов, но наиболее сопоставимыми с IGBT являются мощные MOSFET. Они специально разработаны для работы со значительными уровнями мощности и используются чаще всего только во включенном или выключенном состояниях, что делает их наиболее используемым ключом для низковольтных схем. По сравнению с IGBT, мощные полевые МОП-транзисторы имеют преимущества – более высокую скорость коммутации и более высокую эффективность при работе при низких напряжениях. Более того, такая схема может выдерживать высокое напряжение блокировки и поддерживать высокий ток. Это связано с тем что большинство мощных МОП-структур являются вертикальными (а не плоскими). Номинальное напряжение является прямой функцией легирования и толщины эпитаксиального слоя с примесью N-типа, а ток зависит от ширины канала (чем шире канал, тем выше ток).
Кратко о IGBT
Модуль IGBT также является полностью управляемым коммутатором с тремя контактами (затвор, коллектор и эмиттер). Его управляющий сигнал подается между затвором и эмиттером и нагрузкой между коллектором и эмиттером.

IGBT сочетает в себе простые характеристики управления затвором, как в транзисторе MOSFET, с сильноточным характером биполярного транзистора с низким напряжением насыщения. Это достигается с помощью изолированного полевого транзистора для управляющего входа и биполярного силового транзистора в качестве сильноточного ключа.
Модуль IGBT специально разработан для быстрого включения и выключения. Фактически частота повторения импульсов достигает УЗ диапазона. Эта уникальная способность делает IGBT часто используемыми в усилителях класса D для синтеза сложных сигналов с широтно-импульсной модуляцией и фильтрами нижних частот. Они также используются для генерации импульсов большой мощности в таких областях, как физика элементарных частиц и плазма, а также играют важную роль в современных устройствах – электромобили, электровелосипеды, поезда, холодильники с регулируемой скоростью вращения компрессора, кондиционеры и многое другое.
Сравнение IGBT с MOSFET

Структуры обоих транзисторов очень похожи друг на друга. Что касается протекания тока, важным отличием является добавление слоя подложки P-типа под слой подложки N-типа в структуре модуля IGBT. В этом дополнительном слое дырки вводятся в слой с высоким сопротивлением N-типа, создавая избыток носителей. Это увеличение проводимости в N-слое помогает уменьшить общее напряжение во включенном состоянии в IGBT-модуле. К сожалению, это также блокирует поток электроэнергии в обратном направлении. Поэтому в схему добавлен специальный диод, который расположен параллельно с IGBT чтобы проводить ток в противоположном направлении.
MOSFET может переключаться на более высоких частотах, однако есть два ограничения: время переноса электронов в области дрейфа и время, необходимое для зарядки / разрядки входного затвора и его емкости. Тем не менее эти транзисторы, как правило, достигают более высокой частоты переключения, чем модули IGBT.

Подведем итог
Многие из вышеупомянутых фактов касаются исторической основы обоих устройств. Достижения и технологические прорывы в разработке нового оборудования, а также использование новых материалов, таких как карбид кремния (SiC), привели к значительному улучшению производительности этих радиодеталей за последние годы.
МОП-транзистор:
- Высокая частота переключения.
- Лучшие динамические параметры и более низкое энергопотребление драйвера.
- Более низкая емкость затвора.
- Более низкое термосопротивление, которое приводит к лучшему рассеиванию мощности.
- Более короткое время нарастания и спада, что означает способность работать на более высоких частотах.
IGBT модуль:
- Улучшенная технология производства, которая приводит к снижению затрат.
- Лучшая устойчивость к перегрузкам.
- Улучшенная способность распараллеливания схемы.
- Более быстрое и плавное включение и выключение.
- Снижение потерь при включении и при переключении.
- Снижение входной мощности.
В любом случае модули MOSFET и IGBT быстро заменяют большинство старых полупроводниковых и механических устройств, используемых для управления током. Силовые устройства на основе SiC демонстрируют такие преимущества как меньшие потери, меньшие размеры и более высокая эффективность. Подобные инновации будут продолжать расширять пределы использования MOSFET и IGBT транзисторов для схем с более высоким напряжением и большей мощностью.
Силовые MOSFET и IGBT транзисторы, отличия и особенности их применения
Технологии в области силовой электроники все время совершенствуются: реле становятся твердотельными, биполярные транзисторы и тиристоры заменяются все обширнее на полевые транзисторы, новые материалы разрабатываются и применяются в конденсаторах и т. д. — всюду определенно заметна активная технологическая эволюция, которая не прекращается ни на год. С чем же это связано?
Это связано, очевидно, с тем, что в какой-то момент производители оказываются не в состоянии удовлетворить запросы потребителей на возможности и качество силового электронного оборудования: у реле искрят и обгорают контакты, биполярные транзисторы для управления требуют слишком много мощности, силовые блоки занимают неприемлемо много места и т. п. Производители конкурируют между собой — кто первым предложит лучшую альтернативу…?
Так и появились полевые MOSFET транзисторы, благодаря которым управление потоком носителей заряда стало возможным не посредством изменения тока базы, как у биполярных предков, а посредством электрического поля затвора, по сути — просто приложенным к затвору напряжением.

В итоге уже к началу 2000-х доля силовых устройств на MOSFET и IGBT составляла около 30%, в то время как биполярных транзисторов в силовой электронике осталось менее 20%. За последние лет 15 произошел еще более существенный рывок, и биполярные транзисторы в классическом понимании почти полностью уступили место MOSFET и IGBT в сегменте управляемых силовых полупроводниковых ключей.
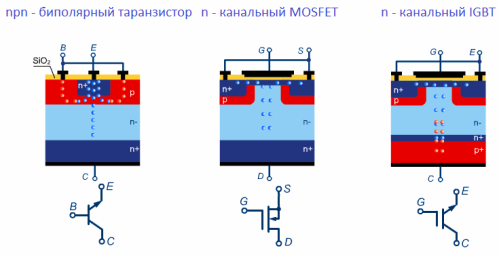
Проектируя, к примеру, силовой высокочастотный преобразователь, разработчик уже выбирает между MOSFET и IGBT – оба из которых управляются напряжением, прикладываемым к затвору, а вовсе не током, как биполярные транзисторы, и цепи управления получаются в результате более простыми. Давайте, однако рассмотрим особенности этих самых транзисторов, управляемых напряжением затвора.
MOSFET или IGBT
У IGBT (БТИЗ-биполярный транзистор с изолированным затвором) в открытом состоянии рабочий ток проходит через p-n-переход, а у MOSFET – через канал сток-исток, обладающий резистивным характером. Вот и возможности для рассеяния мощности у этих приборов различаются, потери получаются разными: у MOSFET-полевика рассеиваемая мощность будет пропорциональна квадрату тока через канал и сопротивлению канала, в то время как у БТИЗ рассеиваемая мощность окажется пропорциональна напряжению насыщения коллектор-эмиттер и току через канал в первой степени.

Если нам нужно снизить потери на ключе, то потребуется выбрать MOSFET с меньшим сопротивлением канала, однако не стоит забывать, что с ростом температуры полупроводника это сопротивление вырастет и потери на нагрев все же возрастут. А вот у IGBT с ростом температуры напряжение насыщения p-n-перехода наоборот снижается, значит и потери на нагрев уменьшаются.
Но не все так элементарно, как может показаться на взгляд неискушенного в силовой электронике человека. Механизмы определения потерь у IGBT и MOSFET в корне различаются.
Как вы поняли, у MOSFET-транзистора сопротивление канала в проводящем состоянии обуславливает определенные потери мощности на нем, которые по статистике почти в 4 раза превосходят мощность, затрачиваемую на управление затвором.
У IGBT дело обстоит с точностью до наоборот: потери на переходе меньше, а вот затраты энергии на управление — больше. Речь о частотах порядка 60 кГц, и чем выше частота — тем больше потери на управление затвором, особенно применительно к IGBT.
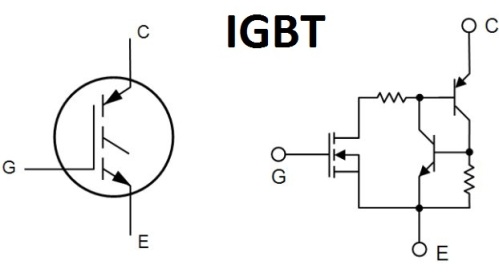
Дело все в том, что в MOSFET неосновные носители заряда не рекомбинируют, как это происходит в IGBT, в составе которого есть полевой MOSFET-транзистор, определяющий скорость открывания, но где база недоступна напрямую, и ускорить процесс при помощи внешних схем нельзя. В итоге динамические характеристики у IGBT ограничены, ограничена и предельная рабочая частота.
Повышая коэффициент передачи и снижая напряжение насыщения — допустим, понизим статические потери, но зато повысим потери при переключении. По этой причине производители IGBT-транзисторов указывают в документации на свои приборы оптимальную частоту и максимальную скорость переключения.
Есть недостаток и у MOSFET. Его внутренний диод отличается конечным временем обратного восстановления, которое так или иначе превышает время восстановления, характерное для внутренних антипараллельных диодов IGBT. В итоге имеем потери включения и токовые перегрузки у MOSFET в полумостовых схемах.
Теперь непосредственно про рассеиваемое тепло. Площадь полупроводниковой IGBT-структуры больше чем у MOSFET, поэтому и рассеиваемая мощность у IGBT больше, вместе с тем температура перехода в процессе работы ключа растет интенсивнее, поэтому важно правильно подобрать радиатор к ключу, грамотно рассчитав поток тепла, приняв в расчет тепловые сопротивления всех границ сборки.
У MOSFET на высоких мощностях также растут потери на нагрев, сильно превосходя потери на управление затвором IGBT. При мощностях выше 300-500Вт и на частотах в районе 20-30 кГц преимущество будет за IGBT-транзисторами.

Вообще, для каждой задачи выбирают свой тип ключа, и есть определенные типовые воззрения на этот аспект. MOSFETы подойдут для работы на частотах выше 20 кГц при напряжениях питания до 300 В — зарядные устройства, импульсные блоки питания, компактные инверторы небольшой мощности и т. д. — подавляющее большинство из них собирают сегодня на MOSFET.
IGBT хорошо работают на частотах до 20 кГц при напряжениях питания 1000 и более вольт — частотные преобразователи, ИБП и т. п. — вот низкочастотный сегмент силовой техники для IGBT-транзисторов.
В промежуточной нише — от 300 до 1000 вольт, на частотах порядка 10 кГц, — подбор полупроводникового ключа подходящей технологии осуществляют сугубо индивидуально, взвешивая все за и против, включая цену, габариты, КПД и другие факторы.
Между тем нельзя однозначно сказать, что в одной типовой ситуации подойдет именно IGBT, а в другой — только MOSFET. Необходимо комплексно подходить к разработке каждого конкретного устройства. Исходя из мощности прибора, режима его работы, предполагаемого теплового режима, приемлемых габаритов, особенностей управления схемой и т.д.
И главное — выбрав ключи нужного типа, разработчику важно точно определить их параметры, ибо в технической документации (в даташите) отнюдь не всегда все точно соответствует реальности. Чем более точно будут известны параметры — тем эффективнее и надежнее получится изделие, независимо от того, идет ли речь об IGBT или о MOSFET.
Надеюсь, что эта статья была для вас полезной. Смотрите также другие статьи в категории Электрическая энергия в быту и на производстве » Практическая электроника
Подписывайтесь на канал в Telegram про электронику для профессионалов и любителей: Практическая электроника на каждый день
Как правильно подключать igbt и mosfet транзисторы
MOSFET транзисторы
Динамика включения MOSFET транзистора
Понятно, что будут рассматриваться лишь n-канальные MOSFET транзисторы, хотя все процессы одинаково справедливы и для их p-канальных сородичей. Эквивалентная схема MOSFET транзистор содержит в своем составе несколько емкостей (раздел «MOSFET-транзисторы»):
— емкость затвор-исток CGS;
— емкость затвор-сток CGD;
— емкость сток-исток CDS.
Эти емкости совместно с другими паразитными элементами оказывают основное влияние на процессы включения и выключения транзистора. Для понимания физики процессов коммутации и пояснения основных временных диаграмм напряжений и токов рассматривается режим коммутации задемпфированной индуктивной нагрузки как наиболее характерный для преобразовательной техники (задемпфированной — потому, что параллельно включен диод, и напряжение на ключе не превысит напряжение источника питания). Соответствующая электрическая схема с основными паразитными элементами представлена на рисунке DRV.1. Эквивалентом индуктивной нагрузки является источник постоянного тока с обратным диодом. Для упрощения считаем ничтожно малым фронт импульса управления на выходе драйвера. Ниже поэтапно представлен процесс включения MOSFET транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.2.
Рисунок DRV.1 — Эквивалентная электрическая схема коммутации индуктивной нагрузки с основными паразитными элементами
Процесс включения MOSFET транзистора состоит из нескольких стадий:
0) Выключенное состояние. На выходе драйвера нулевой уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.
1) Зарядка емкости затвора до напряжения открывания. На выходе драйвера появляется высокий уровень напряжения и начинается процесс заряда ёмкости затвор-исток CGS. Ток ограничивается лишь внутренним сопротивлением драйвера, внешним сопротивлением в цепи затвора и внутренним паразитным сопротивлением затвора транзистора.
Форма импульсов напряжения и токов соответствуют экспоненциальным кривым характерным для RC-цепочек. На протяжении этого периода транзистор пока еще закрыт.
2) Отрывание транзистора, линейный режим. Как только напряжение между затвором и истоком транзистора достигает порогового напряжения открывания UTH то транзистор начинает открываться и переходить в проводящее состояние. Это чисто линейный режим работы транзистора. На этой стадии уже начинает протекать небольшой ток через емкость затвор-сток CGD , называемую емкостью Миллера, что обусловлено падением напряжения на паразитных элементах (сопротивление и индуктивность стока). Напряжение на стоке транзистора практически не изменяется, т.к. протекающий ток еще слишком мал для того чтобы снизить напряжение на стоке до уровня запирания диода, стоящего в цепи источника тока. В течение этого этапа открывания ток через транзистор нарастает от нуля до максимума. В процессе роста тока происходит выделение тепла на кристалле транзистора. Транзистор постепенно переходит в режим называемый «плато Миллера».
3) «Плато Миллера» . После нарастания тока через транзистор до максимума, диод, стоящий в цепи источника тока закрывается и напряжение на стоке транзистора начинает уменьшаться. Все бы было хорошо, но сток и затвор связаны емкостной связью. Из-за этого уменьшение напряжения на стоке приводит перезаряду емкости затвор-сток CGD за счет входного тока драйвера. Ёмкость CGD мала, но заряжена до большого напряжения. Процесс перезаряда забирает на себя весь ток драйвера и в течение этого периода напряжение на затворе не изменяется – временная диаграмма напряжения на затворе имеет вид плато – пресловутого «плато Миллера». Джон Мильтон Миллер — ученый, описавший это дело для электронных ламп. На этой стадии разряжается емкость сток-исток CDS и происходит процесс переключения — уменьшение напряжения на стоке. В условиях индуктивной нагрузки задемпфированной диодом снижение напряжения происходит при токе, уже достигшем номинального значения. На этой стадии происходят основные коммутационные потери на кристалле транзистора.
4) Зарядка емкости затвора до напряжения драйвера. После того как емкость Миллера окончательно перезарядится, ток драйвера вновь пойдет на заряд емкости затвор-исток CGS и напряжение на затворе снова начнет увеличиваться по тем же классическим уравнениям RC-цепочек. Процесс завершится после заряда CGS до напряжения питания драйвера.
5) Включенное состояние. На выходе драйвера максимальный уровень напряжения. Транзистор открыт. Ток протекает через транзистор. Все спокойно. Напряжение на транзисторе определяется падением напряжения на сопротивлении открытого канала. Все спокойно.

Рисунок DRV.2 — Основные этапы включения MOSFET-транзистора
Динамика выключения MOSFET транзистора
Процесс выключения MOSFET транзистора будет рассмотрен для условий, аналогичных вышеприведенным условиям для включения транзистора с той же эквивалентной схемой коммутации индуктивной нагрузки (рисунок DRV.3 схема). Ниже поэтапно представлен процесс выключения MOSFET транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.3.
Процесс выключения MOSFET транзистора состоит из нескольких стадий:
0) Включенное состояние. На выходе драйвера максимальный уровень напряжения (напряжение питания драйвера). Транзистор открыт. Ток протекает через транзистор. Все спокойно. Напряжение на транзисторе определяется падением напряжения на сопротивлении открытого канала. Все спокойно.
1) Разряд емкости затвора до напряжения плато Миллера. На этом этапе происходит разряд емкости затвора и емкости затвор-сток CGS (емкость Миллера) от максимального выходного напряжения драйвера до уровня при котором начинается рост напряжения на стоке и за счет емкостной связи напряжение на затворе устанавливается на некотором уровне – происходит выход на режим «плато Миллера».
2) «Плато Миллера» . Закрывание транзистора приводит к росту напряжения на его стоке. Вследствие емкостной связи между стоком и затвором рост напряжения на стоке приводит к возникновению тока через емкость затвор-сток CGD. Величина этого тока ограничена суммарным сопротивлением затворной цепочки и максимальным входным током драйвера. Когда напряжение стока увеличивается до напряжения питания, то из-за «втекающего в драйвер» тока через емкость затвор-сток CGD напряжение на затворе транзистора не изменяется и временная диаграмма напряжения на затворе имеет вид плато – пресловутого «плато Миллера». На этой стадии заряжается емкость сток-исток CDS и происходит сам процесс выключения — рост напряжения на стоке до напряжения питания, В условиях индуктивной нагрузки ток через транзистор, поддерживаемый источником тока (индуктивность нагрузки) не изменяется. На этой стадии происходят основные коммутационные потери на кристалле транзистора.
3) Закрывание транзистора, линейный режим. После того как ток через емкость Миллера становится меньше разрядного тока драйвера напряжение на затворе начинает уменьшаться — сходит с «плато Миллера». К этому моменту напряжение на транзисторе практически достигает своего максимального значения (однако некоторый рост напряжения все же происходит – за счет увеличения напряжения не величину падения напряжения на диоде). Транзистор переходит в линейный режим и ток через него в течение этого интервала уменьшается до нуля. Ток через транзистор прекращается в момент, когда напряжение на затворе достигает порогового напряжения (напряжение открывания). На этой стадии также имеют место коммутационные потери на кристалле транзистора
4) Разрядка емкости затвора до минимального уровня напряжения драйвера. После того как емкость Миллера окончательно зарядится, ток драйвера полностью пойдет на разряд емкости затвор-исток CGS и напряжение на затворе уменьшиться до уровня минимального выходного напряжения драйвера.
5) Выключенное состояние. На выходе драйвера нулевой уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.

Рисунок DRV.3 — Основные этапы выключения MOSFET-транзистора
Основные выводы по процессу коммутации MOSFET
Анализ временных диаграмм включения/выключения MOSFET-транзистора позволяет сделать следующие практические выводы:
— включение и выключение транзистора происходит в несколько стадий, включающих задержку отклика на управляющее напряжение, собственно сам процесс коммутации и завершение переключения (дозаряд емкостей);
— скорость переключения транзистора пропорциональна входному и выходному току затвора определяемого цепью управления (драйвер, затворный резистор и т.д.); Ток затвора идет на перезарядку собственно емкости затвор-исток, а также паразитной ёмкости затвор-сток из-за которой и возникает «плато Миллера».
— собственно переключение транзистора и основные потери энергии на переключение происходят на этапе соответствующем «плато Миллера». Уменьшая длительность этой стадии можно уменьшить потери на переключение (в идеале…). Отсюда следует, что важно, чтобы драйвер выдавал достаточный входной и выходной ток при прохождении «плато Миллера». В остальных областях – предзаряд до порогового напряжения и постзаряд до выходного напряжения драйвера его выходной ток не оказывает существенного влияния на коммутационные потери.
— при условии ограничения максимального тока затвора внешним резистором ток затвора при включении (т.е. при заряде емкости затвора) больше чем ток затвора при выключении транзистора. То есть в обычных условиях процесс включения транзистора происходит быстрее процесса выключения транзистора. Это обусловлено тем, что заряд емкости затвора и емкости Миллера происходит через суммарную емкость затвора от напряжения примерно 10-15 В (обычный уровень напряжения питания драйвера). А разряд этих емкостей – при напряжении равном напряжению Миллера, т.е. примерно 5 В.
— частота коммутации ограничена сверху временными задержками на переключение транзистора. Для увеличения частоты коммутации необходимо снизить времена переключения ключевого элемента.
Все вышеприведенное относится к качественному рассмотрению процесса коммутации MOSFET. Хорошее описание процесса особенностей коммутации MOSFET дано в [Design And Application Guide For High Speed MOSFET Gate Drive Circuits. By Laszlo Balogh. в сети имеется сильно переработанный русскоязычный перевод – «Разработка и применение высокоскоростных схем управления силовыми полевыми транзисторами»]. Для практического расчета и конструирования источников питания необходим количественный расчет, основные соотношения которого приведены ниже.
IGBT транзисторы
Динамика включения IGBT транзистора
Динамика включения IGBT транзистора в целом схожа с динамикой включения MOSFETтранзистора, но имеет ряд специфических особенностей обусловленных его внутренней структурой. Из условной внутренней структуры (рисунок DRV.4) видно, что IGBT транзистор в своем составе содержит MOSFET транзистор и биполярный p-n-p транзистор.
Рисунок DRV.4 — Условное обозначение и эквивалентная упрощенная внутренняя структура IGBT-транзистора
Кроме внутренней структурной схемы для понимания динамических процессов коммутации IGBT также используют эквивалентную схему IGBT транзистора, содержащую в своем составе несколько емкостей (рисунок DRV.5):
— емкость затвор-эмиттер CGE;
— емкость затвор-коллектор CGC;
— емкость коллектор-эмиттер CCE.
Рисунок DRV.5 — Паразитные емкости IGBT-транзистора
Эти емкости совместно с другими паразитными элементами оказывают основное влияние на процессы включения и выключения транзистора.
Для понимания физики процессов коммутации IGBT-транзистора и пояснения основных временных диаграмм напряжений и токов рассматривается режим коммутации задемфированной индуктивной нагрузки как наиболее характерный для преобразовательной техники. Этот же режим был рассмотрен и для вышеописанных процессов коммутации MOSFET-транзистора. Соответствующая электрическая схема с основными паразитными элементами представлена на рисунке DRV.6. Эквивалентом индуктивной нагрузки является источник постоянного тока с обратным диодом. Для упрощения считаем ничтожно малым фронт импульса управления на выходе драйвера. Кроме этого при управлении IGBT-транзисторами часто используются драйверы, обеспечивающие отрицательный уровень напряжения на затворе, что повышает скорость выключения и обеспечивает защиту от включения в случае резкого увеличения напряжения на затворе. Именно этот случай биполярного драйвера рассмотрен ниже. Ниже поэтапно представлен процесс включения IGBT-транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.7.
Рисунок DRV.6 — Эквивалентная электрическая схема коммутации индуктивной нагрузки IGBT-транзистором с основными паразитными элементами.
Процесс включения IGBT транзистора состоит из нескольких стадий:
0) Выключенное состояние. На выходе драйвера отрицательный относительно эмиттера уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.
1) Зарядка емкости затвор-эмиттер до напряжения открывания. На выходе драйвера появляется высокий уровень напряжения и начинается процесс заряда ёмкости затвор-эмиттер CGE. Ток ограничивается лишь внутренним сопротивлением драйвера, внешним сопротивлением в цепи затвора и внутренним паразитным сопротивлением затвора транзистора. Током драйвера происходит заряд емкости CGE и смена полярности напряжения на затворе. Форма импульсов напряжения и токов соответствуют экспоненциальным кривым характерным для RC-цепочек. На протяжении этого периода транзистор пока еще закрыт.
2) Отрывание транзистора, линейный режим. Как только напряжение между затвором и эмиттером транзистора достигает порогового напряжения открывания UTH то транзистор начинает открываться и переходить в проводящее состояние. При этом первым — включается «MOSFET» транзистор в составе IGBT. Через биполярный транзистор протекает существенно меньшая доля тока. Это чисто линейный режим работы IGBT транзистора. На этой стадии уже начинает протекать небольшой ток через емкость затвор-коллектор CGC, называемую емкостью Миллера, что обусловлено падением напряжения на паразитных элементах (сопротивление и индуктивность вывода коллектора). Напряжение на коллекторе транзистора практически не изменяется, так как протекающий ток еще слишком мал для того чтобы снизить напряжение на коллекторе до уровня запирания диода, стоящего в цепи источника тока (индуктивности). В течение этого этапа открывания транзисторы ток через транзистор нарастает от нуля до максимума. В процессе роста тока происходит выделение тепла на кристалле транзистора. Транзистор постепенно переходит в режим называемый «плато Миллера».
3) «Плато Миллера» — снижение напряжения на «MOSFET» транзисторе в составе IGBT . После нарастания тока через IGBT транзистор до максимума, диод, стоящий в цепи источника тока закрывается и напряжение на коллекторе транзистора начинает уменьшаться. Вследствие ёмкостной связи между коллектором и затвором уменьшение напряжения на коллекторе приводит перезаряду емкости затвор-коллектор CGC за счет входного тока драйвера. Процесс перезаряда забирает на себя весь ток драйвера и в течение этого периода напряжение на затворе не изменяется – временная диаграмма напряжения на затворе имеет вид плато – пресловутого «плато Миллера». Плато Миллера для IGBT транзистора состоит из двух стадий. На первой стадии происходит быстрое снижение напряжения коллекторе обусловленное снижением напряжения на «MOSFET» транзисторе в составе IGBT. На этой стадии имеют место большие коммутационные потери на кристалле транзистора. Вторая стадия плато Миллера — снижение напряжения на биполярном p-n-p транзисторе в составе IGBT. Далее.
4) «Плато Миллера» — снижение напряжения на биполярном p-n-p транзисторе в составе IGBT . После стадии быстрого спада напряжения на коллекторе, обусловленного снижением напряжения на «MOSFET» транзисторе начинается стадия более медленного спада обусловленного процессом завершения включения биполярного p-n-p транзистора в составе IGBT. Аналогично вследствие ёмкостной связи между коллектором и затвором уменьшение напряжения на коллекторе приводит перезаряду емкости затвор-коллектор CGC и в течение этого напряжение на затворе не изменяется – и плато Миллера продолжается до полного включения биполярного p-n-p транзистора после которого напряжение на IGBT устанавливается на уровне падения напряжения на открытом переходе транзистора. Это вторая стадия плато Миллера для IGBT транзистора. На этой стадии также имеют место коммутационные потери на кристалле транзистора.
5) Зарядка емкости затвора до напряжения драйвера. После того как емкость Миллера окончательно перезарядится, ток драйвера вновь пойдет на заряд емкости затвор-эмиттер CGEи напряжение на затворе снова начнет увеличиваться по тем же классическим уравнениям RC-цепочек. Процесс завершится после заряда CGE до напряжения питания драйвера. Практически весь ток полностью протекает через биполярный p-n-p транзистор в составе IGBT транзистора.
6) Включенное состояние. На выходе драйвера максимальный уровень напряжения. Транзистор открыт. Все спокойно. Напряжение на транзисторе определяется падением напряжения на переходе открытого транзистора. Все спокойно.

Рисунок DRV.7 — Основные этапы включения IGBT-транзистора
Динамика выключения IGBT транзистора
Процесс выключения IGBT транзистора будет рассмотрен для условий аналогичных вышеприведенным условиям для эквивалентной схемы коммутации индуктивной нагрузки. Поэтапно ниже представлен процесс выключения IGBT транзистора. Временные диаграммы и направления протекания токов представлены на рисунке DRV.8.
Процесс выключения IGBT транзистора .
0) Включенное состояние. На выходе драйвера максимальный уровень напряжения (напряжение питания драйвера). Транзистор открыт. Ток протекает через транзистор. Все спокойно. Напряжение на транзисторе определяется падением напряжения на сопротивлении открытого канала. Все спокойно.
1) Разряд емкости затвора до напряжения плато Миллера. На этом этапе происходит разряд емкости затвора и емкости затвор-сток CGE (емкость Миллера) от максимального выходного напряжения драйвера до уровня при котором начинается рост напряжения на коллекторе и за счет емкостной связи напряжение на затворе устанавливается на некотором уровне – происходит выход на режим «плато Миллера». Важно понимать, что для IGBTтранзистора имеется значительная разница между напряжениями на «плато Миллера» для включения и выключения. Это обусловлено задержкой подключения обратной связи, так как биполярная часть IGBT транзистора достаточно «тормозная» и рост напряжения на коллекторе начинается уже после того как напряжение успело спасть до напряжения несколько ниже порога включения.
2) «Плато Миллера» . Закрывание IGBT транзистора приводит к росту напряжения на его коллекторе. Вследствие емкостной связи между коллектором и затвором рост напряжения на стоке приводит к возникновению тока через емкость коллектор-сток CGC. Величина этого тока ограничена суммарным сопротивлением затворной цепочки и максимальным входным током драйвера. Вследствие этого тока обратной связи напряжение на затворе транзистора не изменяется во время пока напряжение на транзисторе увеличивается. То есть ток драйвера и «ток Миллера» друг друга полностью компенсируют, при этом временная диаграмма напряжения на затворе имеет вид «плато Миллера». На этой стадии заряжается емкость коллектор-эмиттер CCE и происходит сам процесс выключения — рост напряжения на коллекторе до напряжения питания. Ток через транзистор, поддерживаемый источником тока (цепь нагрузки), не изменяется. На этой стадии происходят основные коммутационные потери на кристалле транзистора. При этом важно понимать, что на этой стадии ток перераспределяется между обоими транзисторами, входящими в состав IGBT — «MOSFET» транзистором и p-n-p BT-транзистором.
3) Закрывание транзистора, выключение «MOSFET» транзистора в составе IGBT. После того как ток через емкость Миллера становится меньше разрядного тока драйвера напряжение на затворе начинает уменьшаться (сход с «плато Миллера»). К этому моменту напряжение на транзисторе практически достигает своего максимального значения. Далее следует быстрое уменьшение тока через транзистор до определенной величины – происходит выключение — «MOSFET» транзистора в составе IGBT. Напряжение на затворе продолжает спадать.
4) Перезарядка емкости затвора до минимального уровня напряжения драйвера. После того как емкость Миллера окончательно зарядится, ток драйвера полностью пойдет на разряд емкости затвор-эмиттер CGE и напряжение на затворе снизится уровня минимального выходного напряжения драйвера (отрицательного относительно «земли», как правило).
4-5) Закрывание транзистора, выключение биполярного p-n-p транзистора в составе IGBT.
После стадии быстрого спада тока транзистора, обусловленного выключением «MOSFET» транзистора в составе IGBT начинается стадия более медленного спада тока, обусловленного выключением биполярного p-n-p транзистора в составе IGBT. Это так называемый «токовый хвост». Длина «хвоста» определяется типом транзистора и величиной ранее протекавшего тока. На этой стадии также происходят существенные коммутационные потери.
6) Выключенное состояние. На выходе драйвера минимальный уровень напряжения. Транзистор закрыт. Ток индуктивности замыкается через обратный диод. Все спокойно.

Рисунок DRV.8 Основные этапы выключения IGBT-транзистора
Основные выводы по процессу коммутации IGBT
Из временных диаграмм видно, что в целом процесс включения/выключения IGBTтранзистора схож с процессом коммутации MOSFET транзистора. Таким образом, выводы сделанные выше для MOSFET применимы и для IGBT. Однако имеются некоторые основные отличия в процессе коммутации IGBT. Выделим их:
— наличие ступенчатого спада напряжения на коллекторе в процессе включения, что обусловлено составным характером IGBT транзистора: сначала включается MOSFET-часть, затем биполярная часть;
— наличие ступенчатого спада тока на коллекторе в процессе выключения, что также обусловлено составным характером IGBT транзистора: сначала выключается MOSFET-часть, затем биполярный транзистор. К тому же процесс выключения биполярного p-n-p транзистора затягивается и имеет место так называемый «токовый хвост». Опасность «хвоста» проявляется в значительных сквозных токах при включении IGBT в схему полумоста.
— уровни «плато Миллера» для включения и выключения транзистора различны. При включении IGBT уровень «плато Миллера» больше чем уровень «плато Миллера» при выключении. Это обусловленной временной задержкой включения отрицательной обратной связи между коллектором и затвором.
— IGBT транзистор более медленный по сравнению с MOSFET.
Все вышеприведенное относится к качественному рассмотрению процесса коммутации IGBT транзистора. Хорошее описание процесса особенностей коммутации IGBT дано в [Markus Hermwille. IGBT Driver Calculation. Application Note AN-7004, SEMIKRON International. Русскоязычный перевод в журнале «Электронные компоненты №6, №8. 2008 — Управление изолированным затвором. Часть 1, Часть 2. Маркус Хермвиль, Андрей Колпаков.]. Проблемы потерь при переключении описаны в [DRIVE CIRCUITS FOR POWER MOSFETs AND IGBTs. by B. Maurice, L. Wuidart. APPLICATION NOTE. STMicroelectronics]. Принципы управления MOSFET и IGBT представлены в статье [Управление изолированными затворами MOSFET/IGBT, базовые принципы и основные схемы. Винтрич Арендт, Николаи Ульрих, Райманн Тобиас, Турски Вернер. Силовая электроника, №5, 2013]. Для практического расчета и конструирования источников питания необходим количественный расчет, основные соотношения которого приведены ниже.
Расчет параметров цепи управления MOSFET-транзисторов
Для определения требований к цепи управления MOSFET необходим расчет основных электрических параметров в цепи затвора транзистора. В целом нижеприведенные соотношения справедливы и для расчета управления IGBT-транзисторов.
Заряд затвора
Основным параметром, используемым при расчете цепей управления MOSFET является заряд затвора QG. Он приводится в справочных листах (datasheet) на транзисторы. Кроме численного значения, которое можно найти в datasheet, важно понимать, что QG зависит от напряжения на транзисторе VDS. Зависимости напряжения на затворе VGS от «вкачанного» в него заряда QG также приводятся в datasheet. В качестве примера на рисунке DRV.9 представлена зависимость для популярного транзистора IRF740. Видно, что зависимость содержит отражение «плато Миллера».
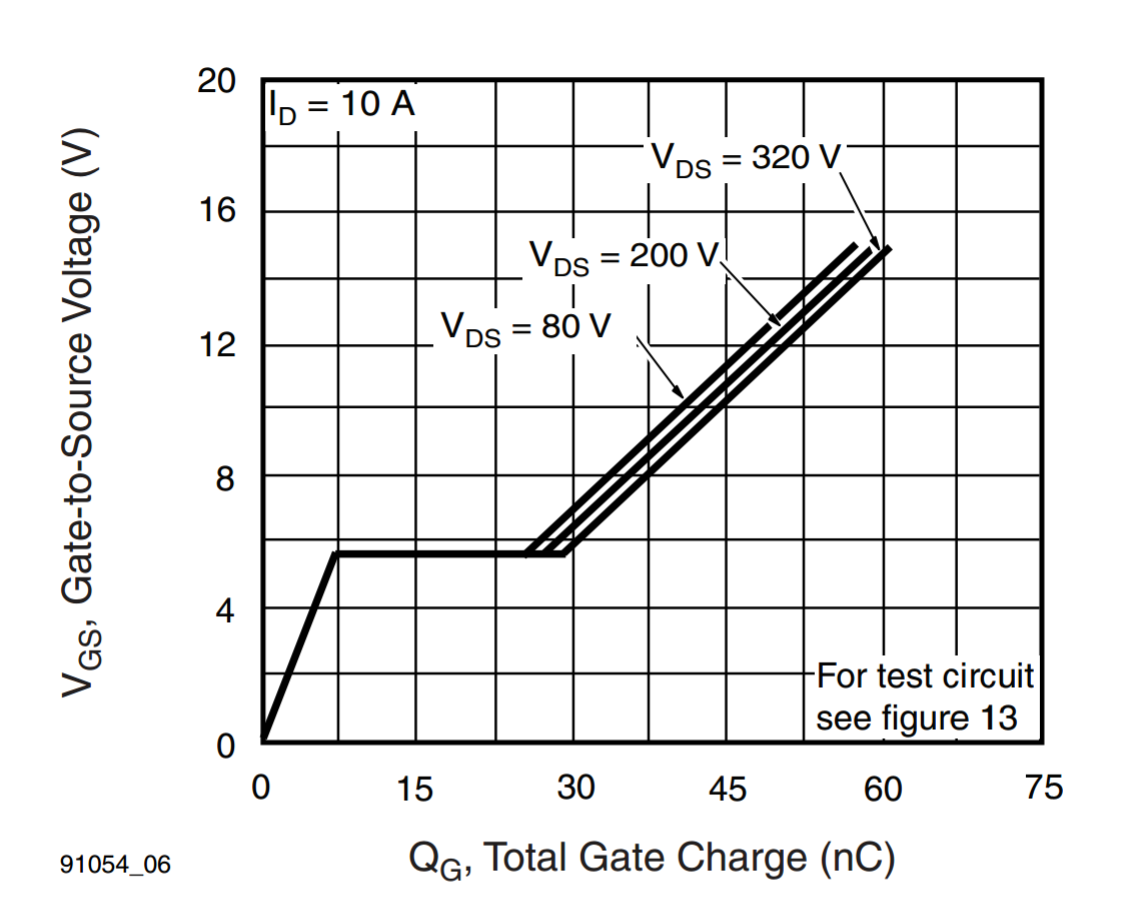
Рисунок DRV.9 — Зависимость напряжения на затворе от заряда затвора для популярного транзистора IRF740 (по данным datasheet от Vishay Siliconix)
В соответствии графиком можно определить весьма точно величину суммарного заряда затвора при заданном напряжении драйвера и напряжении VGS на транзисторе.
Мощность управления
Выражение для мощности управления затвором PG_avg имеет вид:

Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
QG — заряд затвора (total gate charge);
f – частота коммутации.
Эта мощность рассеивается на резистивных элементах цепи управления – затворном резисторе, внутреннем сопротивлении драйвера, паразитном сопротивлении затвора.
Средний ток управления MOSFET
Средний ток IG_avg, потребляемый схемой управления на перезаряд емкости затвора равен:

QG — заряд затвора (total gate charge);
f – частота коммутации.
Это было среднее значение. Теперь раскладываем импульс тока управления по полочкам, находим токи на каждом из интервалов и длительности интервалов.
Напряжение «плато Миллера»
Напряжение «плато Миллера» VMiller определяется выражением:

VTH – пороговое напряжение (открывания транзистора);
ID_max – максимальный ток стока;
gfs – крутизна зависимости тока стока от напряжения затвора на малом сигнале:

Как правило, вторая компонента суммы, обусловленная крутизной gfs значительно меньше VTH по величине и на практике её можно не учитывать.
Токи и времена коммутации на стадии включения
— амплитуда импульса тока затвора IG_max (в начальный момент времени) равна:

Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
Rdriver_ON – внутреннее сопротивление драйвера на стадии включения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
В случае если выходной каскад драйвера работает как генератор тока, то максимальный ток равен максимальному выходному току драйвера.
— ток затвора в линейном режиме IG_lin — в период времени между VTH и VMiller равен:

VMiller – напряжение на «плато Миллера»;
VTH – пороговое напряжение включения транзистора.
Смысл полсуммы заключается в усреднении VTH и VMiller для получения среднего значения напряжения на интервале.
— ток затвора на «плато Миллера» IG_Miller равен:

— длительность времени нарастания напряжения до порога открывания VTH (в первом приближении):

Ciss — входная емкость (Input Capacitance).
— длительность линейного режима (период времени между VTH и VMiller):

Ciss — входная емкость (Input Capacitance).
На практике длительность этого интервала достаточно мала (поскольку VTH≈VMiller) и может быть исключена из расчета.
— длительность «плато Миллера» :

Crss — проходная емкость (Reverse Transfer Capacitance).
VDS – напряжение сток-исток на выключенном транзисторе.
Смысл этого выражения заключается в том, что ток на «плато Миллера» фактически перезаряжает «ёмкость Миллера» Crss заряженную до напряжения сток-исток выключенного транзистора.
Особенно важным интервалом является интервал соответствующий «плато Миллера» поскольку именно на этом интервале происходят основные коммутационные потери.
Для упрощения расчетов по вышеприведенным соотношениям можно допустить, что:

При этом длительность линейного режима обращается в ноль и исключается из расчета. Таким образом, время спада напряжения на транзисторе в момент включения tf определяетсядлительностью «плато Миллера»:


Crss — проходная емкость (Reverse Transfer Capacitance), зависит от напряжения сток-исток VDS;
VDS – напряжение сток-исток на выключенном транзисторе;
Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
VMiller – напряжение на «плато Миллера», практически равно VTH – пороговому напряжению включения транзистора;
Rdriver_ON – внутреннее сопротивление драйвера на стадии включения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
Токи и времена коммутации на стадии выключения
— амплитуда импульса тока затвора в начальный момент времени выключения транзистора равна:

Rdriver_OFF – внутреннее сопротивление драйвера на стадии выключения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
В случае если выходной каскад драйвера работает как генератор тока, то максимальный ток равен максимальному выходному току драйвера.
— ток затвора на «плато Миллера» на стадии выключения транзистора равен:

— ток затвора в линейном режиме — период времени между VTH и VMiller равен:

VMiller – напряжение на «плато Миллера»;
VTH – пороговое напряжение включения транзистора.
— длительность времени спада напряжения до напряжения VMiller «плато Миллера» (в первом приближении):

— длительность «плато Миллера»:

— длительность линейного режима (период времени между VTH и VMiller):

На практике длительность этого интервала достаточно мала (поскольку VTH≈VMiller) и может быть исключена из расчета.
Таким образом, время нарастания напряжения на транзисторе при переходе в закрытое состояние tr определяется длительностью «плато Миллера»:


Crss — проходная емкость (Reverse Transfer Capacitance), зависит от напряжения сток-исток VDS;
VDS – напряжение сток-исток на выключенном транзисторе;
Vdriver – амплитуда управляющего напряжения затвора (напряжения драйвера);
VMiller – напряжение на «плато Миллера», практически равно VTH – пороговому напряжению включения транзистора;
Rdriver_OFF – внутреннее сопротивление драйвера на стадии выключения;
RG_ext – внешнее сопротивление в цепи затвора;
RG_int – внутреннее сопротивление затвора транзистора.
Основные коммутационные потери транзистора происходят именно на интервале, соответствующему «плато Миллера».
Шунтирующий конденсатор драйвера. Расчет
Выше показано, что управление MOSFET транзистором в ключевом режиме осуществляешься импульсами тока, перезаряжающего паразитные емкости. Амплитуда этих импульсов может составлять единицы ампер при временах нарастания – менее 100 нс. Из этого следует, что для формирования данных импульсов драйвер должен иметь источник энергии с малым внутренним сопротивлением, причем расположенный в непосредственной близости от драйвера.
Таким источником энергии является шунтирующий конденсатор драйвера, за счет энергии которого осуществляется питание драйвера в моменты коммутации. Для этой ответственной роли подходят только керамические конденсаторы. Вопрос в том какова должна быть минимальная емкость шунтирующего конденсатора? При закачивании в затвор суммарного заряда затвора QG напряжение на шунтирующем конденсаторе изменится на величину ΔVCdrv :

QG – суммарный заряд затвора;
CDRV – емкость шунтирующего конденсатора.
Отсюда следует выражение для емкости шунтирующего конденсатора CDRV:

QG – суммарный заряд затвора;
ΔVCdrv – допустимые пульсации на шунтирующем конденсаторе.
Таким образом, для расчета величины емкости необходимо задаться величиной допустимых пульсаций на шунтирующем конденсаторе. Они могут быть выбраны в пределах 2-5 %.
Расчет (определение) внутреннего сопротивления драйвера
Внутреннее выходное сопротивление драйвера на стадии включения Rdriver_ON, если не указано в datasheet, может быть вычислено по соотношению:

Vdriver – номинальное напряжение драйвера;
Idriver_max_ON – максимальный выходной ток драйвера на стадии включения.
Аналогично рассчитывается внутреннее входное сопротивление драйвера на стадии выключения Rdriver_OFF :

Vdriver – номинальное сопротивление драйвера;
Idriver_max_OFF – максимальный входной ток драйвера на стадии выключения.
Выбор оптимального сопротивления затворного резистора
Критерий демпфирования осцилляций
Цепь, или вернее токовая петля, по которой протекает ток управления транзистором (ток затвора) имеет собственную индуктивность. Эта индуктивность во-первых замедляет рост тока в цепи затвора, во-вторых – приводит к появлению высокочастотных осцилляций в цепи затвора обусловленных LC-контуром, образованном емкостью затвора и паразитной индуктивностью цепи. Прямым путем решения проблем является оптимизация разводки печатной платы с целью уменьшения паразитных индуктивностей там, где они не нужны. Но в любом случае уменьшить индуктивность до нуля не получится.
Для демпфирования осцилляций используется внешний резистор затвора. Его величинаRG_extвыбирается исходя из соотношения [Design And Application Guide For High Speed MOSFET Gate Drive Circuits. By Laszlo Balogh. В сети имеется сильно переработанный русскоязычный перевод – «Разработка и применение высокоскоростных схем управления силовыми полевыми транзисторами»]:

LS – паразитная индуктивность контура;
Сiss – входная емкость транзистора;
RG_int – паразитное сопротивление затвора транзистора;
Rdriver – внутреннее сопротивление (среднее) драйвера:

Физический смысл этого соотношения для нахождения оптимального сопротивления контура заключается в том, чтобы сделать активное сопротивление затворного резистора равным удвоенному волновому сопротивлению LC контура. При этом колебания эффективно демпфируются.
Критерий ограничения тока драйвером
Для каждого типа драйвера существует максимальное значение входного и выходного тока. Это накладывает ограничения на минимальную величину сопротивления в цепи затвора ниже которой оно не оказывает существенного значения на динамические характеристики, т.к. ток ограничивается уже самим драйвером.
В общем случае (пренебрегаем паразитным сопротивлением затвора и ограничением тока драйвером) максимальное значение импульса тока затвора IG_max равно:

Vdriver – максимальное выходное напряжение драйвера;
RG_ext – сопротивление затворного резистора.
Приравнивая максимальное значение импульса тока затвора IG_max к максимальному значению тока драйвера Idriver_max :

Получаем минимальную величину сопротивления затвора RG_ext:

Vdriver – максимальное выходное напряжение драйвера;
Idriver_max – максимальное значение тока драйвера (выбирается как минимальное из Idriver_max_ON и Idriver max OFF).
Выбирая затворное сопротивление больше данной величины уменьшают скорость переключения транзистора. Зачем необходимо уменьшать скорость переключения транзистора – см. далее.
Критерий устойчивости к высоким dV/dt на закрытом транзисторе
Существует предельно допустимая скорость нарастания напряжения на закрытом транзисторе, иначе он может приоткрыться (об этом ниже в подразделе «Высокие скорости нарастания напряжения на транзисторе (dV/dt) – причины и следствия»).
Предельно допустимая скорость нарастания напряжения прикладываемого к закрытому транзистору (dV/dt)max определяется по соотношению:

VTH – напряжение открывания драйвера (берется с учетом рабочей температуры);
CGD – емкость затвор-сток;
RG_total – суммарное сопротивление затвора:

RG_ext – выбранное значение сопротивление затворного резистора;
RG_int – паразитное сопротивление затвора транзистора;
Rdriver_OFF – внутреннее сопротивление драйвера в состоянии OFF (соотношение для расчета представлено выше).
Если рассчитанное значение (dV/dt)max больше реальной скорости роста напряжения в данной схеме (dV/dt)real, то все в порядке. Если же нет, то скорость роста напряжения нужно уменьшить или уменьшить суммарное сопротивление затвора RG_total.
Критерий заданного времени включения/выключения транзистора
В ряде случаев необходимо искусственно замедлить скорость коммутации транзистора. Необходимость этого может быть обусловлена снижением dV/dt в схеме, ограничению броска тока при коммутации снижением уровня наводок и т.д. В этом случае увеличением величины затворного резистора добиваются повышения времени коммутации в соответствии с соотношением:

где dV/dt – заданная скорость нарастания напряжения.
Высокие скорости нарастания напряжения на транзисторе (dV/dt) – причины и следствия
Причины высоких dV/dt на закрытом транзисторе и последствия
В большинстве схемотехнических решений преобразователей используется последовательное соединение двух поочередно включающихся силовых ключей MOSFET или IGBT-транзисторов. К таким схемам относятся схемы полумостовых, мостовых преобразователей, синхронных выпрямителей, системы управления двигателями и др. С целью уменьшения динамических потерь необходимо увеличивать скорости переключения силовых ключей. Динамические потери при этом уменьшаются, но возникает опасность «несанкционированного» включения транзистора за счет тока, протекающего через емкость затвор-сток. Включение может быть как полным, так и может быть переход в линейный режим. Следствие этого включения – «сквозняк» — сквозной ток через оба силовых транзистора и выход преобразователя из строя.
Кроме этих типичных случаев, высокие dV/dt на транзисторе могут возникать при:
— включении питания преобразователя (когда еще драйвер «молчит»);
— резком разрыве тока в индуктивностях силовой схемы;
С особым вниманием следует отнестись к устройствам, работа которых предполагает значительный нагрев силовых ключей. Рост температуры кристалла приводит к уменьшению порогового напряжения открывания транзистора.
При проектировании преобразовательной техники необходимо определить входит ли конкретная схема в группу риска. Необходимо понимать, что емкости затвор-сток и затвор-исток образуют емкостной делитель, максимальное выходное напряжение на котором (напряжение на затворе) при любой скорости роста напряжения dV/dt не превысит величины:

VGS_max – максимальное напряжение на затворе;
VDS_max – максимальное напряжение на транзисторе (сток-исток), или максимально возможное напряжение на транзисторе;
CGS – емкость затвор-исток;
CGD – емкость затвор-сток.
Если напряжение VGS_max окажется меньше порогового напряжения открывания транзистора VTH :

то в данных условиях схема находится вне зоны риска по dV/dt.

то необходимо принимать дополнительные меры, о которых указано ниже.
Риск «паразитного включения» существенно возрастает с ростом рабочего напряжения на стоке. Вместе с тем при малых рабочих напряжениях (как правило, менее 24 В) случайного открывания транзистора по причине высоких dV/dt можно не опасаться.
Способы защиты от высоких значений dV/dt
Резистор в цепи затвор-исток
Использование резистора подключаемого параллельно затвору и истоку транзистора «помогает» лишь при сравнительно малых скоростях роста напряжения на транзисторе. Однако это весьма действенный способ устранения «паразитного включения» при подаче питания на устройство. Дело в том, что при подаче питания некоторые драйверы могут еще находится в спящем режиме и его выходные каскады могут быть в неактивном состоянии и не «притягивать» затвор к земле. В этот период времени пассивный способ с помощью резистора обеспечивает защиту затвора. Величина резистора RGSвыбирается исходя из соотношения:

VTH – напряжение открывания драйвера (берется с учетом рабочей температуры);
CGD – емкость затвор-сток;
dV/dt – скорость роста напряжения на транзисторе.
Разрядный резистор физически необходимо располагать непосредственно вблизи силового ключа. Недостатком способа является значительная дополнительная нагрузка на выходной каскад драйвера в течение всего импульса открытого состояния ключа.
Схема на p-n-p транзисторе
Схема на p-n-p транзисторе (см. рисунок DRV.14), ускоряющая выключение транзистора так же эффективна для защиты транзистора от включения в результате действия больших dV/dt. При использовании схемы максимальная скорость нарастания напряжения на силовом MOSFETопределяется из соотношения:

VTH – напряжение открывания драйвера (берется с учетом рабочей температуры);
CGD – емкость затвор-сток;
β – коэффициент усиления по току p-n-p транзистора;
RG_ext – выбранное значение сопротивление затворного резистора;
Rdriver_OFF – внутреннее сопротивление драйвера в состоянии OFF;
RG_int – паразитное сопротивление затвора.
Расчет статических и динамических потерь при коммутации MOSFET
Основные соотношения для расчета коммутационных потерь представлены в статье [Проблема выбора ключевых силовых транзисторов для преобразователей напряжения с жестким переключением. Александр Полищук. Силовая электроника №2, 2004 г.].
Статические потери
Мощность статических потерь для MOSFET транзисторов PVT_stat определяется выражением:

Irms – среднеквадратичное значение тока через транзистор;
RDS – сопротивление сток-исток в открытом состоянии.
Динамические потери
Динамические потери MOSFET – транзисторов состоят из трех составляющих:
— энергия, выделяемая в кристалле при коммутации тока нагрузки I при рабочем напряжении V:

I – ток нагрузки;
Vpow – напряжение питания;
tf – время спада напряжения на транзисторе (в момент коммутации);
tr – время нарастания напряжения на транзисторе (переход в закрытое состояние).
— энергия разряда выходной емкости транзистора, заряженной до напряжения питания:

Vpow – напряжение питания;
Сoss – выходная емкость транзистора:

СGD – ёмкость «затвор–сток»;
СDS – ёмкость «сток-исток».
— энергия, выделяемая при протекании реверсного тока восстановления паразитного диода:

Qrr – заряд восстановления паразитного диода;
Vpow – напряжение питания.
Величина заряда восстановления паразитного диода транзистора Qrr приведена в datasheet для определенных режимов работы, как правило, соответствующих высоким скоростям изменения тока через транзистор и величинах тока, близких к максимальному). Таким образом, использование «даташитного» значения Qrr даст величину потерь близкую к очень наихудшему случаю. Для более точных расчетов целесообразно корректировать Qrrсогласно соотношению:

Qrr_datasheet – значение заряда восстановления паразитного диода транзистора данная в datasheet;
IF_datasheet – значение прямого тока протекающего через паразитный диод транзистора при котором получено значение Qrr_datasheet ;
IF – значение прямого тока протекающего через паразитный диод транзистора в реальных условиях соответствующих расчету.
Общие динамические потери при переключении транзистора складываются из трех составляющих:


Переходя от суммарной энергии динамических потерь в каждом цикле к мощности потерь PVT_switch, получим выражение:

f – частота коммутации.
I – ток нагрузки;
Vpow – напряжение питания;
tf – время спада напряжения на транзисторе (переход в открытое состояние);
tr – время нарастания напряжения на транзисторе (переход в закрытое состояние);
Qrr – заряд восстановления паразитного диода;
Сoss – выходная емкость транзистора:

СGD – ёмкость «затвор–сток»;
СDS – ёмкость «сток-исток».
Расчет статических и динамических потерь при коммутации IGBT
Основные соотношения для расчета коммутационных потерь представлены в статье [Проблема выбора ключевых силовых транзисторов для преобразователей напряжения с жестким переключением. Александр Полищук. Силовая электроника №2, 2004 г.].
Статические потери
Для IGBT статические потери рассчитываются по соотношению:

Iavg – среднее значение тока через транзистор;
VCE – напряжение насыщения перехода коллектор-эмиттер транзистора.
Соотношение справедливо при условии, что ток нагрузки на протяжении периода коммутации изменяется незначительно.
Динамические потери
Динамические потери IGBT – транзисторов состоят из трех составляющих:
— энергия, выделяемая в кристалле при переключении. Для IGBT-транзисторов, в отличие от MOSFET используется понятие энергии переключения Ets которая учитывает потери различного рода, в том числе потери, определяемые «хвостом» остаточного тока при выключении:

Ets – суммарная энергия переключения;
— энергия разряда выходной емкости транзистора, заряженной до напряжения питания:

Vpow – напряжение питания;
Сoes – выходная емкость транзистора:

СGC – ёмкость «затвор–коллектор»;
СCE – ёмкость «коллектор-эмиттер».
— энергия, выделяемая при протекании реверсного тока восстановления специально введенного оппозитного диода (при наличии такового внутри IGBT):

Qrr – заряд восстановления оппозитного диода;
Vpow – напряжение питания.
Величина заряда восстановления оппозитного диода IGBT-транзистора Qrr приведена в datasheet для определенных режимов работы, как правило, соответствующих высоким скоростям изменения тока через транзистор и величинах тока, близких к максимальному). Таким образом, использование «даташитного» значения Qrr даст величину потерь близкую к очень наихудшему случаю. Для более точных расчетов целесообразно корректировать Qrrсогласно соотношению:

Qrr_datasheet – значение заряда восстановления оппозитного диода транзистора данная в datasheet;
IF_datasheet – значение прямого тока протекающего через оппозитный диод транзистора при котором получено значение Qrr_datasheet ;
IF – значение прямого тока протекающего через оппозитный диод транзистора в реальных условиях соответствующих расчету.
Общие динамические потери при переключении транзистора складываются из трех составляющих:


Переходя от суммарной энергии динамических потерь в каждом цикле к мощности потерь, получим выражение:

f – частота коммутации;
Ets – суммарная энергия переключения;
Vpow – напряжение питания;
Qrr – заряд восстановления оппозитного диода;
Сoes – выходная емкость транзистора:

СGC – ёмкость «затвор–коллектор»;
СCE – ёмкость «коллектор-эмиттер».
Драйверы класса «TrueDrive»
Как показано при описаниях процессов коммутации важно, чтобы драйвер MOSFET/IGBTтранзистора выдавал максимальный выходной ток при прохождении через «плато Миллера». Это существенно уменьшает динамические коммутационные потери на силовом ключе. В настоящее время существуют драйверы, выходной каскад которых обеспечивает высокий выходной и входной ток в районе «плато Миллера» — так называемые драйверы класса «TrueDrive». Их отличительной особенностью является использование в выходном каскаде как полевых, так и биполярных транзисторов. Структура такого драйвера представлена на рисунке DRV.10 на примере драйверов серий UCC27*** и UCC37***.
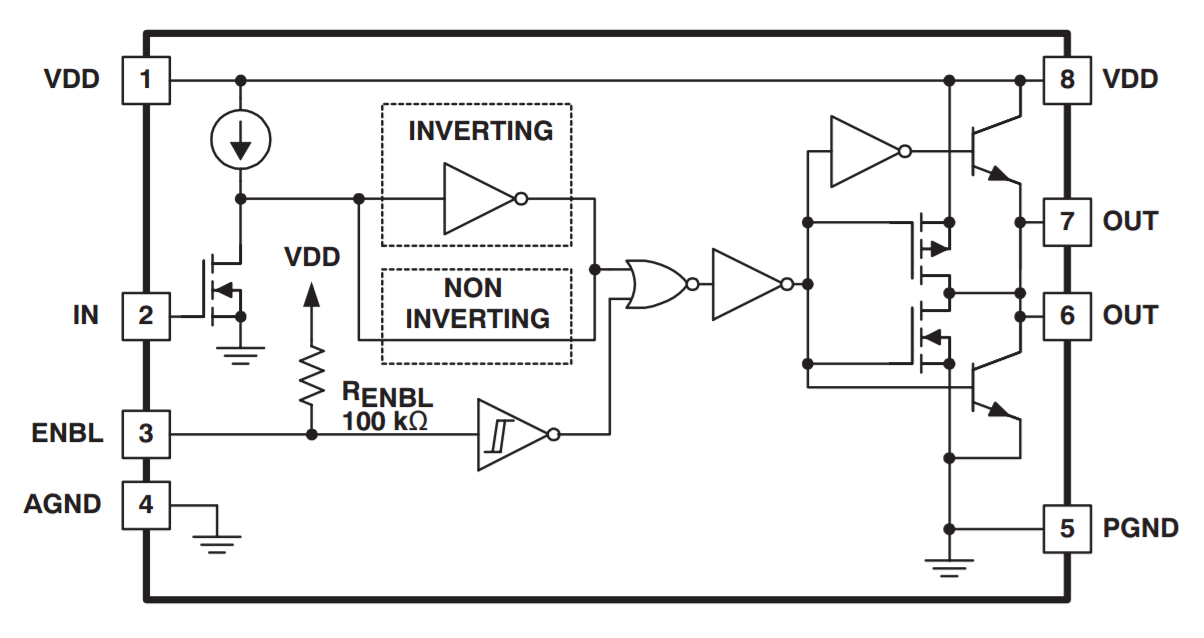
Рисунок DRV.10 — Структура драйвера типа «TrueDrive» [datasheet UCC27321 от Texas Instruments Incorporated]
Ряд типовых схемотехнических решений управления затвором
Ниже представлен ряд типовых схемотехнических решений управления затвором используемых при необходимости в тех или иных случаях.
Схема с затворным резистором
Стандартная схема управления с резистором в цепи затвора (рисунок DRV.11) – наиболее распространенное схемотехническое решение. Затворный резистор демпфирует возможные осцилляции в паразитном LC-контуре, и ограничивает скорость включения и выключения MOSFET-транзистора. Данная схема подходит в большинстве случаев для стандартных источников питания малой и средней мощности. Рекомендации по расчету величины сопротивления затворного резистора представлены выше.
Рисунок DRV.11 — Стандартная схема управления с резистором в цепи затвора
Схема с обратным диодом в цепи затвора
Схема управления с обратным разрядным диодом в цепи затвора обеспечивает ускоренное выключение MOSFET-транзистора так как разряд емкости затвора происходит в обход затворного резистора «всей мощью тока драйвера». За счет этого сокращаются динамические потери на ключе. Это особенно актуально в тех случаях, когда необходимо замедлить процесс включения ключа (для ограничения максимальной dV/dt на другом ключе, или для уменьшения броска тока или для других целей) и одновременно минимизировать время его выключения. Кроме этого обратный диод повышает стойкость схемы к «паразитной коммутации» при высоких скоростях роста напряжения dV/dt на закрытом ключе. В качестве диода могут быть использованы быстродействующие маломощные кремниевые диоды типа 1N4148 (для токов до 1 А). Применение в схеме диодов Шоттки нежелательно по причине их большой емкости перехода по сравнению с кремниевыми диодами и возникающих вследствие этого осцилляций в паразитном LC контуре [Схемы управления затворами силовых транзисторов. А.М. Бобрешов, А.В. Дыбой, С.Ватхик, М.С. Куролап. ВЕСТНИК ВГУ. Серия: Физика. Математика. 2010. №2. с. 189-197]. Существует минимальное значение сопротивления затвора RG, при котором диод открывается:

VVD – падение напряжения на паразитном диоде;
IG_max – пиковый ток затвора.
В остальном рекомендации по расчету величины сопротивления затворного резистора для данной схемы аналогичны рекомендациям для предыдущей схемы и представлены выше.
Недостатком схемы является значительная токовая нагрузка на драйвер на стадии выключения.
Рисунок DRV.12 Схема управления с обратным разрядным диодом в цепи затвора
Схема с независимо задаваемыми скоростями включения и выключения транзистора
Фактически представляет собой комбинацию предыдущих схем. Схема позволяет независимо задавать скорости включения и выключения MOSFET-транзистора. Рекомендации по расчету величины сопротивления затворного резистора для данной схемы аналогичны рекомендациям для предыдущей схемы.
Рисунок DRV.13 — Схема управления с отдельно задаваемыми скоростями включения и выключения транзистора.
Схема управления с разрядным p-n-p транзистором
Данная схема обеспечивает ускоренный разряд емкости затвора, обеспечивает хорошую стойкость к высоким dV/dt. Маломощный p-n-p транзистор располагается в непосредственной близости к силовому MOSFET и обеспечивает короткий путь разряда емкости затвора в процессе выключения. Выбор транзистора осуществляется исходя из обеспечения высокого быстродействия и достаточного коэффициента усиления по току. Сопротивление резистора RGопределяет только скорость включения транзистора. Данное схемотехническое решение применяется в преобразователях средней и большой мощности. Преимуществом схемы является уменьшение нагрузки на выходной каскад драйвера (практически в два раза), поскольку разряд емкости затвора осуществляется через внешний транзистор.
Рисунок DRV.14 — Схема управления с разрядным p-n-p транзистором
Схема с дополнительным разрядным MOSFET- транзистором
В схеме осуществляется быстрый разряд затвора силового MOSFET за счет маломощного MOSFET-транзистора. Среди недостатков данного решения следует отнести необходимость дополнительного инверсного выхода драйвера. Схема обладает высоким быстродействием.
Рисунок DRV.15 — Схема управления с дополнительным разрядным MOSFET- транзистором
Схема с усилителем тока на комплементарных биполярных транзисторах
Схема управления с усилителем тока на комплементарных биполярных транзисторах (рисунок DRV.16) применяется при управлении «тяжелыми» затворами, когда выходного тока драйвера недостаточно для быстрого перезаряда емкости затвора.
Рисунок DRV.16 — Схема управления с усилителем тока на комплементарных биполярных транзисторах
Схема с усилителем тока на MOSFET транзисторах
Схема управления с усилителем тока на MOSFET транзисторах (рисунок DRV.17) также используется при управлении «тяжелыми» затворами, когда выходного тока драйвера недостаточно для быстрого перезаряда емкости затвора. К отличительным особенностям схемы относятся инверсия сигнала управления, и несколько большее быстродействие.
Рисунок DRV.17 Схема управления с усилителем тока на MOSFET транзисторах
Схема с усилителем тока на биполярных транзисторах c различными скоростями включения/выключения
Схема управления с усилителем тока на биполярных транзисторах c различными скоростями включения/выключения силового MOSFET транзистора используется в случае управления «тяжелыми» затворами при одновременном условии независимой установки скоростей включения и выключения транзистора.
Рисунок DRV.18 — Схема управления с усилителем тока на биполярных транзисторах cразличными скоростями включения/выключения транзистора
Пробой затвора ключевого транзистора: причины и способы защиты
Причины пробоя затвора
Пробой затвора ключевого MOSFET- или IGBT транзистора может произойти вследствие ряда причин:
— превышение амплитуды управляющих импульсов напряжения пробоя затвора. Встречается редко, но вполне возможно, в случае если питание драйвера не стабилизировано.
— паразитная генерация в контуре «емкость затвора»-«индуктивность цепи управления» (так называемый «звон»). Причинами этого являются отсутствие или малая величина сопротивления затворных резисторов и слишком длинная цепь управления с большой паразитной индуктивностью и высокие скорости переключения.
— наводка в цепи управления за счет индуктивной (трансформаторной связи) между слишком длинной и широкой петлей управления и слишком близкорасположенным и слишком быстрым и сильноточным силовым контуром.
— слишком быстрый рост напряжения на стоке (коллекторе), вызывающий существенный ток через переходную емкость сток-затвор и рост напряжения на затворе.
— статическое электричество. Но это скорее при монтаже схемы.
— увеличение импеданса цепи управления.
Способы защиты от пробоя затвора
Существует несколько способов защиты от пробоя затвора (рисунок DRV.19):
— резистор в цепи «затвор-исток». Демпфирует колебания в цепи «драйвер-затвор» и снижает амплитуду колебаний. Менее эффективен, чем затворный резистор, но зато он практически не снижает разрядный зарядный ток. Устанавливается в непосредственной близости к транзистору. Основной целью введения резистора в управляющие схемы является предотвращение избыточного «перезаряда» входной емкости затвора при увеличении импеданса цепи управления [Подключение сигнальных цепей в мощных преобразовательных устройствах. Андрей Колпаков. Новости электроники №15. 2008. Статья 9].
— суппресор TVS в цепи «затвор-исток». Существенно более эффективная, но дорогая защита. Суппресор также ставится в непосредственной близости от транзистора.
— диод Шоттки, установленный между затвором и цепью питания.
— комбинированная защита, включающая суппресор TVS и резистор для предотвращения избыточного «перезаряда» емкости затвора.
— маломощный MOSFET-транзистор, включающийся при превышении затворного напряжения определенного уровня, задаваемого резисторным делителем R1/R2. Эта схема предназначена больше для мощных IGBT-транзисторов.
Рисунок DRV.19 — Реализация защиты от перенапряжения на затворе MOSFET и IGBT — транзисторов
Защита от пробоя затвора актуальна в случае, если драйвер и силовой ключ разнесены на значительное расстояние. Это является причиной возникновения наводок и паразитных осцилляций. В этих случаях может быть целесообразно использование транзисторов с повышенным максимальным напряжением затвор-исток (например ±30В вместо ±20В).
Как правильно подключать igbt и mosfet транзисторы
Силовые MOSFET и IGBT транзисторы, отличия и особенности их применения
Технологии в области силовой электроники все время совершенствуются: реле становятся твердотельными, биполярные транзисторы и тиристоры заменяются все обширнее на полевые транзисторы, новые материалы разрабатываются и применяются в конденсаторах и т. д. — всюду определенно заметна активная технологическая эволюция, которая не прекращается ни на год. С чем же это связано?
Это связано, очевидно, с тем, что в какой-то момент производители оказываются не в состоянии удовлетворить запросы потребителей на возможности и качество силового электронного оборудования: у реле искрят и обгорают контакты, биполярные транзисторы для управления требуют слишком много мощности, силовые блоки занимают неприемлемо много места и т. п. Производители конкурируют между собой — кто первым предложит лучшую альтернативу…?
Так и появились полевые MOSFET транзисторы, благодаря которым управление потоком носителей заряда стало возможным не посредством изменения тока базы, как у биполярных предков, а посредством электрического поля затвора, по сути — просто приложенным к затвору напряжением.

В итоге уже к началу 2000-х доля силовых устройств на MOSFET и IGBT составляла около 30%, в то время как биполярных транзисторов в силовой электронике осталось менее 20%. За последние лет 15 произошел еще более существенный рывок, и биполярные транзисторы в классическом понимании почти полностью уступили место MOSFET и IGBT в сегменте управляемых силовых полупроводниковых ключей.
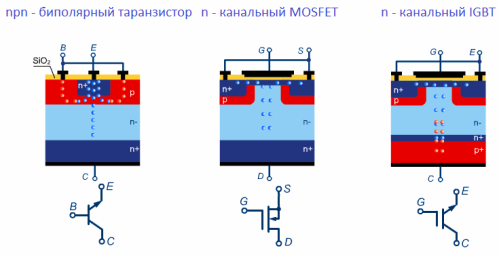
Проектируя, к примеру, силовой высокочастотный преобразователь, разработчик уже выбирает между MOSFET и IGBT – оба из которых управляются напряжением, прикладываемым к затвору, а вовсе не током, как биполярные транзисторы, и цепи управления получаются в результате более простыми. Давайте, однако рассмотрим особенности этих самых транзисторов, управляемых напряжением затвора.
MOSFET или IGBT
У IGBT (БТИЗ-биполярный транзистор с изолированным затвором) в открытом состоянии рабочий ток проходит через p-n-переход, а у MOSFET – через канал сток-исток, обладающий резистивным характером. Вот и возможности для рассеяния мощности у этих приборов различаются, потери получаются разными: у MOSFET-полевика рассеиваемая мощность будет пропорциональна квадрату тока через канал и сопротивлению канала, в то время как у БТИЗ рассеиваемая мощность окажется пропорциональна напряжению насыщения коллектор-эмиттер и току через канал в первой степени.

Если нам нужно снизить потери на ключе, то потребуется выбрать MOSFET с меньшим сопротивлением канала, однако не стоит забывать, что с ростом температуры полупроводника это сопротивление вырастет и потери на нагрев все же возрастут. А вот у IGBT с ростом температуры напряжение насыщения p-n-перехода наоборот снижается, значит и потери на нагрев уменьшаются.
Но не все так элементарно, как может показаться на взгляд неискушенного в силовой электронике человека. Механизмы определения потерь у IGBT и MOSFET в корне различаются.
Как вы поняли, у MOSFET-транзистора сопротивление канала в проводящем состоянии обуславливает определенные потери мощности на нем, которые по статистике почти в 4 раза превосходят мощность, затрачиваемую на управление затвором.
У IGBT дело обстоит с точностью до наоборот: потери на переходе меньше, а вот затраты энергии на управление — больше. Речь о частотах порядка 60 кГц, и чем выше частота — тем больше потери на управление затвором, особенно применительно к IGBT.
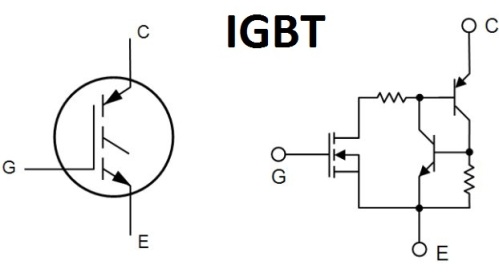
Дело все в том, что в MOSFET неосновные носители заряда не рекомбинируют, как это происходит в IGBT, в составе которого есть полевой MOSFET-транзистор, определяющий скорость открывания, но где база недоступна напрямую, и ускорить процесс при помощи внешних схем нельзя. В итоге динамические характеристики у IGBT ограничены, ограничена и предельная рабочая частота.
Повышая коэффициент передачи и снижая напряжение насыщения — допустим, понизим статические потери, но зато повысим потери при переключении. По этой причине производители IGBT-транзисторов указывают в документации на свои приборы оптимальную частоту и максимальную скорость переключения.
Есть недостаток и у MOSFET. Его внутренний диод отличается конечным временем обратного восстановления, которое так или иначе превышает время восстановления, характерное для внутренних антипараллельных диодов IGBT. В итоге имеем потери включения и токовые перегрузки у MOSFET в полумостовых схемах.
Теперь непосредственно про рассеиваемое тепло. Площадь полупроводниковой IGBT-структуры больше чем у MOSFET, поэтому и рассеиваемая мощность у IGBT больше, вместе с тем температура перехода в процессе работы ключа растет интенсивнее, поэтому важно правильно подобрать радиатор к ключу, грамотно рассчитав поток тепла, приняв в расчет тепловые сопротивления всех границ сборки.
У MOSFET на высоких мощностях также растут потери на нагрев, сильно превосходя потери на управление затвором IGBT. При мощностях выше 300-500Вт и на частотах в районе 20-30 кГц преимущество будет за IGBT-транзисторами.

Вообще, для каждой задачи выбирают свой тип ключа, и есть определенные типовые воззрения на этот аспект. MOSFETы подойдут для работы на частотах выше 20 кГц при напряжениях питания до 300 В — зарядные устройства, импульсные блоки питания, компактные инверторы небольшой мощности и т. д. — подавляющее большинство из них собирают сегодня на MOSFET.
IGBT хорошо работают на частотах до 20 кГц при напряжениях питания 1000 и более вольт — частотные преобразователи, ИБП и т. п. — вот низкочастотный сегмент силовой техники для IGBT-транзисторов.
В промежуточной нише — от 300 до 1000 вольт, на частотах порядка 10 кГц, — подбор полупроводникового ключа подходящей технологии осуществляют сугубо индивидуально, взвешивая все за и против, включая цену, габариты, КПД и другие факторы.
Между тем нельзя однозначно сказать, что в одной типовой ситуации подойдет именно IGBT, а в другой — только MOSFET. Необходимо комплексно подходить к разработке каждого конкретного устройства. Исходя из мощности прибора, режима его работы, предполагаемого теплового режима, приемлемых габаритов, особенностей управления схемой и т.д.
И главное — выбрав ключи нужного типа, разработчику важно точно определить их параметры, ибо в технической документации (в даташите) отнюдь не всегда все точно соответствует реальности. Чем более точно будут известны параметры — тем эффективнее и надежнее получится изделие, независимо от того, идет ли речь об IGBT или о MOSFET.
Управление мощной нагрузкой постоянного тока. Часть 3.
Кроме транзисторов и сборок Дарлингтона есть еще один хороший способ рулить мощной постоянной нагрузкой — полевые МОП транзисторы.
Полевой транзистор работает подобно обычному транзистору — слабым сигналом на затворе управляем мощным потоком через канал. Но, в отличии от биполярных транзисторов, тут управление идет не током, а напряжением .
МОП (по буржуйски MOSFET ) расшифровывается как Метал-Оксид-Полупроводник из этого сокращения становится понятна структура этого транзистора.
Если на пальцах, то в нем есть полупроводниковый канал который служит как бы одной обкладкой конденсатора и вторая обкладка — металлический электрод, расположенный через тонкий слой оксида кремния, который является диэлектриком. Когда на затвор подают напряжение, то этот конденсатор заряжается, а электрическое поле затвора подтягивает к каналу заряды, в результате чего в канале возникают подвижные заряды, способные образовать электрический ток и сопротивление сток — исток резко падает. Чем выше напряжение, тем больше зарядов и ниже сопротивление, в итоге, сопротивление может снизиться до мизерных значений — сотые доли ома, а если поднимать напряжение дальше, то произойдет пробой слоя оксида и транзистору хана.
Достоинство такого транзистора, по сравнению с биполярным очевидно — на затвор надо подавать напряжение, но так как там диэлектрик, то ток будет нулевым, а значит требуемая мощность на управление этим транзистором будет мизерной , по факту он потребляет только в момент переключения, когда идет заряд и разряд конденсатора.
Недостаток же вытекает из его емкостного свойства — наличие емкости на затворе требует большого зарядного тока при открытии. В теории, равного бесконечности на бесконечно малом промежутки времени. А если ток ограничить резистором, то конденсатор будет заряжаться медленно — от постоянной времени RC цепи никуда не денешься.
МОП Транзисторы бывают P и N канальные. Принцип у них один и тот же, разница лишь в полярности носителей тока в канале. Соответственно в разном направлении управляющего напряжения и включения в цепь. Очень часто транзисторы делают в виде комплиментарных пар. То есть есть две модели с совершенно одиннаковыми характеристиками, но одна из них N, а другая P канальные. Маркировка у них, как правило, отличается на одну цифру.
Нагрузка включается в цепь стока. Вообще, в теории, полевому транзистору совершенно без разницы что считать у него истоком, а что стоком — разницы между ними нет. Но на практике есть, дело в том, что для улучшения характеристик исток и сток делают разной величины и конструкции плюс ко всему, в мощных полевиках часто есть обратный диод (его еще называют паразитным, т.к. он образуется сам собой в силу особенности техпроцесса производства).
У меня самыми ходовыми МОП транзисторами являются IRF630 (n канальный) и IRF9630 (p канальный) в свое время я намутил их с полтора десятка каждого вида. Обладая не сильно габаритным корпусом TO-92 этот транзистор может лихо протащить через себя до 9А. Сопротивление в открытом состоянии у него всего 0.35 Ома.
Впрочем, это довольно старый транзистор, сейчас уже есть вещи и покруче, например IRF7314 , способный протащить те же 9А, но при этом он умещается в корпус SO8 — размером с тетрадную клеточку.
На более мелких транзисторах сорудить цепочку, подающую питалово с высоковольтной цепи на затвор, чтобы прокачать его высоким напряжением
Выбор транзистора тоже не очень сложен, особенно если не заморачиваться на предельные режимы. В первую очередь тебя должно волновать значение тока стока — I Drain или I D выбираешь транзистор по максимальному току для твоей нагрузки, лучше с запасом процентов так на 10. Следующий важный для тебя параметр это V GS — напряжение насыщения Исток-Затвор или, проще говоря, управляющее напряжение. Иногда его пишут, но чаще приходится выглядывать из графиков. Ищешь график выходной характеристики Зависимость I D от V DS при разных значениях V GS . И прикидыываешь какой у тебя будет режим.
Вот, например, надо тебе запитать двигатель на 12 вольт, с током 8А. На драйвер пожмотился и имеешь только 5 вольтовый управляющий сигнал. Первое что пришло на ум после этой статьи — IRF630. По току подходит с запасом 9А против требуемых 8. Но глянем на выходную характеристику:
Видишь, на 5 вольтах на затворе и токе в 8А падение напряжения на транзисторе составит около 4.5В По закону Ома тогда выходит, что сопротивление этого транзистора в данный момент 4.5/8=0.56Ом . А теперь посчитаем потери мощности — твой движок жрет 5А. P=I*U или, если применить тот же закон Ома, P=I 2 R . При 8 амперах и 0.56Оме потери составят 35Вт. Больно дофига, не кажется? Вот и мне тоже кажется что слишком. Посмотрим тогда на IRL630 .
При 8 амперах и 5 вольтах на Gate напряжение на транзисторе составит около 3 вольт. Что даст нам 0.37Ом и 23Вт потерь, что заметно меньше.
Если собираешься загнать на этот ключ ШИМ, то надо поинтересоваться временем открытия и закрытия транзистора, выбрать наибольшее и относительно времени посчитать предельную частоту на которую он способен. Зовется эта величина Switch Delay или t on , t off , в общем, как то так. Ну, а частота это 1/t. Также не лишней будет посмотреть на емкость затвора Ciss исходя из нее, а также ограничительного резистора в затворной цепи, можно рассчитать постоянную времени заряда затворной RC цепи и прикинуть быстродействие. Если постоянная времени будет больше чем период ШИМ, то транзистор будет не открыватся/закрываться, а повиснет в некотором промежуточном состоянии, так как напряжение на его затворе будет проинтегрировано этой RC цепью в постоянное напряжение.
При обращении с этими транзисторами учитывай тот факт, что статического электричества они боятся не просто сильно, а ОЧЕНЬ СИЛЬНО . Пробить затвор статическим зарядом более чем реально. Так что как купил, сразу же в фольгу и не доставай пока не будешь запаивать. Предварительно заземлись за батарею и надень шапочку из фольги :).
А в процессе проектирования схемы запомни еще одно простое правило — ни в коем случае нельзя оставлять висеть затвор полевика просто так — иначе он нажрет помех из воздуха и сам откроется. Поэтому обязательно надо поставить резистор килоом на 10 от Gate до GND для N канального или на +V для P канального, чтобы паразитный заряд стекал. Вот вроде бы все, в следующий раз накатаю про мостовые схемы для управления движков.
Спасибо. Вы потрясающие! Всего за месяц мы собрали нужную сумму в 500000 на хоккейную коробку для детского дома Аистенок. Из которых 125000+ было от вас, читателей EasyElectronics. Были даже переводы на 25000+ и просто поток платежей на 251 рубль. Это невероятно круто. Сейчас идет заключение договора и подготовка к строительству!
А я встрял на три года, как минимум, ежемесячной пахоты над статьями :)))))))))))) Спасибо вам за такой мощный пинок.
332 thoughts on “Управление мощной нагрузкой постоянного тока. Часть 3.”
Да, я сейчас в Кургане и буду тут дней десять. Если кто есть с Кургана можно забухать! А то скучновато тута…
IGBT или MOSFET? Практика выбора
Действительно, нет в силовой электронике двух других элементов, развивающихся столь быстро и имеющих так много схожих черт, как транзисторы IGBT и MOSFET . Естественно, при определенных условиях работы выбор должен быть однозначен. Например, для низковольтного высокочастотного DC/DC-конвертора любой разработчик, не задумываясь, применит MOSFET. Однако в области высоких напряжений (более 300 В) и относительно низких частот (10…50 кГц) выбор оптимального элемента становится серьезной проблемой. Ошибка в выборе может привести к тому, что ваше устройство не сможет реализовать свои возможности, будет рассеивать слишком большую мощность, и в итоге, станет неконкурентоспособным.
Следует подчеркнуть, что проблема состоит не только в определении типа элемента — IGBT или MOSFET. Часто бывает очень важно выбрать и изготовителя, тем более, что на рынке силовых полупроводников идет жесткая конкуренция. Иногда труднее отдать предпочтение кому-либо из производителей, чем найти подходящий элемент.
В статье приведены конкретные методики выбора силового ключа для некоторых типовых, наиболее распространенных схем включения, дан краткий обзор сравнительных характеристик элементов ведущих мировых производителей.
1. ОБЩИЕ ПОЛОЖЕНИЯ
1.1. Потери проводимости
Появление на рынке силовых полупроводников транзисторов IGBT и быстрое их распространение объясняется врожденными недостатками, присущими MOSFET. В первую очередь, это большое сопротивление открытого канала высоковольтных полевых транзисторов.
Как известно, сопротивление R DS(on) растет почти пропорционально квадрату пробивного напряжения. Иногда это утверждение описывается соотношением:
где a=1,6…2,5 (по данным разных производителей).
Выпрямленное напряжение промышленной сети составляет, примерно, 310 В для сети 220 В и 540 В для сети 380 В. Для безопасной работы современных силовых ключей рекомендуется использовать транзисторы с напряжением, на 200 В превышающим напряжение питания (такие рекомендации содержатся в документах фирмы International Rectifier и некоторых других). Объясняется это, в частности, тем, что при скоростях изменения напряжений и токов, которые обеспечивают MOSFET и IGBT-транзисторы (время их коммутации составляет десятки наносекунд), выбросы напряжения за счет паразитных индуктивностей подводящих проводов и выводов конденсаторов могут привести к отказу элемента. Справедливости ради надо отметить, что в последние годы для защиты от переходных перенапряжений появилось много специальных элементов с отличными характеристиками (например, диоды TRANSIL фирмы ST-Microelectronics), да и сами элементы способны выдерживать лавинный пробой со значительно й энергетикой. Однако требование осталось, и разработчики хотят иметь транзисторы на напряжение, не менее 500 В для сетей 220 В и 800 В для питающих сетей 380 В.
Статические потери (или потери проводимости) MOSFET пропорциональны квадрату тока и сопротивлению открытого канала:
P D =I d 2 *R DS(on) .
Транзисторы с меньшим сопротивлением канала имеют больший размер кристалла, больший заряд затвора и, соответственно, все связанные с этим проблемы.
У IGBT транзисторов потери проводимости зависят от тока, практически, линейно:
Напряжение U ce открытого транзистора тоже, в свою очередь, зависит от тока. Соответствующие графики, также как и значение R DS(on) обязательно приводятся в технических данных на транзисторы, и расчет статических потерь обычно не представляет трудности. Некоторые проблемы могут быть связаны с тем, что во время периода проводимости ток может изменяться. Характер этого изменения зависит от конфигурации схемы. Для упрощения расчета энергии проводимости существует таблица 1.
Кроме того, падение напряжения на открытом транзисторе зависит от температуры, причем зависимость эта — положительная для MOSFET и отрицательная для IGBT. На графике рис. 1 приведена зависимость напряжения открытого транзистора для двух IGBT-транзисторов с разным быстродействием и MOSFET-транзистора, имеющего аналогичный размер кристалла . Ввиду большей стойкости MOSFET к лавинному пробою, 500-вольтовый полевой транзистор сравнивается с IGBT, рассчитанным на напряжение 600 В.

Общее представление о соотношении предельного рабочего напряжения и напряжения открытого транзистора дает приведенная ниже таблица 2, в которой падение напряжения измерено при одной и той же плотности тока и температуре кристалла.

Рисунок и таблица наглядно показывают, насколько потери проводимости для высоковольтных полевых транзисторов больше, чем у аналогичных IGBT.
1.2. Потери переключения
Во многом решая проблему высоковольтных применений, IGBT тоже имеют врожденный дефект, и он носит название «хвост» (tail). Этот эффект объясняется наличием остаточного тока коллектора после выключения транзистора из-за конечного времени жизни неосновных носителей в области базы PNP-транзистора (см. рис. 2). Поскольку база недоступна, ускорить время выключения схемными методами нельзя.

Для сокращения «хвоста» существуют технологические приемы и у современных транзисторов он уже гораздо меньше, чем у IGBT первых поколений. Однако полностью подавить хвост не удается, и это приводит к тому, что энергия выключения намного больше энергии включения (см. рис. 3).

Борьба за высокие динамические характеристики и сокращение потерь переключения приводит к росту потерь проводимости и достичь оптимальных результатов тут невозможно. В свою очередь, снижение статических потерь, а это достигается, в частности, за счет увеличения коэффициента передачи PNP-транзистора и снижения напряжения насыщения, приводит к росту потерь переключения. Поэтому все ведущие производители IGBT выпускают транзисторы с разным быстродействием для применения на разных частотах. Например, International Rectifier выпускает IGBT следующих частотных классов:
W — High Efficiency WARP Speed — на частоты 75…150 кГц;
U — High Efficiency Ultra-Fast Speed — на частоты 10…75 кГц;
F — High Efficiency Fast Speed — на частоты 3…10 кГц;
S — High Efficiency Standard Speed — на частоты 1…3 кГц.
Разницу в частотных характеристиках этих транзисторов вы можете увидеть на рис. 4.

К счастью для разработчиков, значение энергии выключения E off , приводимое в справочных данных лучших производителей, учитывает наличие «хвоста», что упрощает расчет потерь. С изготовителями транзисторов, которые не дают таких данных, мы бы не рекомендовали связываться.
Как может показаться из сказанного, MOSFET-транзисторы имеют сплошные преимущества в области потерь переключения. Однако это далеко не так. Портит картину тельный или внутренний (но не встроенный!) диод ( body diode ) полевого транзистора. Характеристики его обратного восстановления (заряд Q rr , время t rr ) оказываются гораздо хуже, чем у специальных диодов с малым временем обратного восстановления, которые применяются в качестве антипараллельных диодов в IGBT. Например, у транзистора IGR4PC40UD заряд обратного восстановления диода — Q rr 100 нК, а время обратного восстановления t rr 50 нс. Для транзистора IRF840LC те же параметры составляют Q rr 3 мкК и t rr 500 нс! Причем речь идет о полевом транзисторе с улучшенными частотными свойствами ( LC — Low Charge ).
К чему же это может привести? В полумостовых и мостовых схемах через открывающийся транзистор текут ток нагрузки (ограниченный, естественно, параметрами нагрузки) и ток обратного восстановления диода оппозитного транзистора, ограниченный только характеристиками проводимости. На рис. 5 показан ток коллектора транзистора, включающегося на индуктивную нагрузку в полумостовой схеме при условии быстрого (слева) и идеального (справа) оппозитного диода. Разница между левой и правой эпюрами показывает вклад процесса обратного восстановления в энергию включения. И этот вклад, как правило, учитывается в значении энергии включения E on . Параметр I lm (максимальный ток на индуктивной нагрузке) гарантирует, что транзистор способен коммутировать ток индуктивной нагрузки и при этом обеспечивать прямоугольную область безопасной работы (ОБР) в режиме тяжелого переключения, т.е. при большом токе и высоком напряжении одновременно. Конечно, все сказанное относится к лучшим производителям, таким как International Rectifier, SIEMENS, IXYS и некоторым другим . Наше мнение о не лучших производителях см. выше.

Большой заряд обратного восстановления тельных диодов MOSFET приводит к большим потерям включения и токовым перегрузкам в полумостовых схемах. Для решения этой проблемы рекомендуется исключать диод включением двух быстрых диодов последовательно — параллельно. При этом, естественно, растут потери проводимости. С зарядом внутреннего диода тоже ведется технологическая борьба и небезуспешно. В MOSFET пятого поколения производства International Rectifier заряд Q rr снижен в несколько раз. К сожалению, такие транзисторы выпускаются только на напряжение менее 100 В.
Разработчика, имеющего дело с конкретными схемами, прежде всего интересуют не общие соображения, а конкретная методика выбора элемента. Далее мы постараемся дать рекомендации по такому выбору для некоторых типовых схем. Мы не будем рассматривать типы корпусов и вопросы технологии производства кристаллов, эта тема достаточно подробно освещена в статье Е. Дуплякина. Основой для выбора того или иного транзистора послужит сравнение суммарной мощности потерь.
2. ПРАКТИЧЕСКИЕ РЕКОМЕНДАЦИИ
Для корректного сравнения мы будем использовать транзисторы в тех режимах, где выбор представляет собой наибольшую проблему. Во всех схемах напряжение питания будет 310 В, ток (пиковое значение) — 5…7 А, частота — 20 кГц и 50 кГц, коэффициент заполнения — 0,5 (для того, чтобы «уравнять в правах» потери проводимости и потери переключения), R g =10 Ом (импеданс схемы управления затвором).
Для сравнения выберем тран- зисторы, имеющие одинаковые кристаллы, корпуса и подходящие по предельным значениям указанным требованиям. Некоторые основные характеристики сравниваемых транзисторов приведены в таблице 3.
U br — максимальное рабочее напряжение; I max — максимальный ток (коллектора или стока); P d — максимальная рассеиваемая мощность; Q g — суммарный заряд затвора; Q rr — заряд обратного восстановления антипараллельного диода; R jc — тепловое сопротивление кристалл — корпус; R cs — тепловое сопротивление «корпус — теплосток»; E on — энергия включения; E off — энергия выключения; E ts — суммарная энергия потерь.
При расчете используются следующие формулы:
A. Мощность статических потерь транзистора MOSFET:
P D1 =Id 2 *R DS(on) *D,
I d — среднее значение тока стока за период проводимости;
R DS(on) — сопротивление открытого канала;
B. Мощность статических потерь транзистора IGBT:
P D2 =I c *U ce *D,
I c — ток коллектора;
U ce — напряжение насыщения.
При этом расчете необходимо учитывать зависимость U ce =f(I c ), приводимую в технических данных.
С. Мощность динамических потерь транзистора MOSFET без учета тока обратного восстановления оппозитного диода в режиме «тяжелого» переключения:
P SW1 =(2*U s *I d *Q g /I g )*F,
U s — напряжение питания.
Ток затвора I g можно примерно определить как отношение разности максимального напряжения на затворе U gs и напряжения, соответствующего заряду емкости Миллера U gm , к импедансу схемы управления за-твором:
I g =(U gs — U gm )/R g .
Напряжение U gm определяется по горизонтальному участку на графике V gs =f(Q g ) . Для IRF840 U gm 5 В (см. рис. 6).

D. Мощность динамических потерь транзистора IGBT в режиме «тяжелого» переключения:
P SW2 =E ts ( I c R g )*F,
Здесь E ts ( I c R g ) — энергия потерь с учетом тока коллектора и импеданса цепи управления. Она определяется по графикам E ts =f(R g ) и E ts =f(I c ) .
Значение E ts учитывает «хвост» и потери от обратного восстановления оппозитного диода.
Е. Мощность динамических потерь транзистора MOSFET с учетом тока обратного восстановления оппозитного диода в режиме «тяжелого» переключения:
P SW3 =U s (I l *t a +0,5Q rr )*F,
I l — ток нагрузки,
ta — составляющая времени обратного восстановления trr, пока напряжение на диоде остается близким к нулю (примерно равно времени включения, как видно из рис. 5).
Точной формулы для оценки динамических потерь с учетом тока обратного восстановления не существует и приведенное выражение выведено с некоторыми упрощениями. Однако для приблизительной оценки его точности вполне достаточно.
2.1. Однотактная схема
Для максимального приближения к реальности в схему введена паразитная индуктивность L1=100 нГн, учитывающая влияние подводящих проводов и печатных линий. Все графики получены с помощью моделирования схем на PSPICE . При расчетах использованы математические модели транзисторов MOSFET и IGBT , разработанные специалистами International Rectifier и автором статьи. Модели имеют очень высокую степень достоверности, что подтверждено специальными тестами.
На рис. 7 приведена схема, а соответствующие эпюры на рис. 8: энергия потерь, напряжение и ток (сверху вниз) при использовании IGBT . Обратите внимание на то, насколько энергия выключения больше энергии включения. В такой схеме отсутствуют потери, связанные с восстановлением диода. Поскольку паразитная индуктивность L1 затягивает фронт тока, потерями включения можно пренебречь.

Результаты расчетов сведены в таблицу 4.

Значение температуры кристалла T j определяется по формуле:
T j = P S *(R jc +R cs )+T s .


Расчет температуры кристалла должен завершать разработку схемы, т. к. он позволяет проверить правильность всех остальных расчетов и определить запас по тепловому режиму, который во многом определяет надежность схемы. Т s — температура теплостока, которую мы приняли равной 70 0 С. Это вполне реальное значение, соответствующее температуре окружающей среды 40 0 С и площади радиатора 20 см 2 /Вт.
Как видно из таблицы, в такой схеме даже на частоте 50 кГц транзисторы IGBT имеют преимущество из-за меньших потерь проводимости.
В такой схеме мы имеем практически все виды потерь. Рассмотрим наихудший случай, когда за время выключенного транзистора ток нагрузки спадает незначительно. При этом включение транзистора происходит при полном токе. Поскольку в качестве оппозитного диода используется диод с малым значением Q rr , динамические потери включения MOSFET меньше, чем могли бы быть при его работе в полумосте с аналогичным транзистором. При расчетах использовалась модель диода HFA04TB60 .
На рис. 10 показаны эпюры, соответствующие данной схеме. Отметьте, как возросли потери включения из-за обратного восстановления диода. На графике тока коллектора виден пик при включении транзистора, образующийся в процессе восстановления диода.

Результаты расчетов сведены в таблицу 5.

В данной схеме потери транзисторов IGBT на частоте 50 кГц превышают потери MOSFET. Из-за большего значения теплового сопротивления перегрев кристалла IGBT также оказывается больше, что делает применение полевых транзисторов в таком режиме предпочтительным.
2.3. Полумостовая схема
с индуктивной нагрузкой
На рис.11 приведена соответствующая тестовая схема, а на рис.12 — эпюры. С точки зрения мощности потерь главное отличие от предыдущей схемы состоит в том, что при включении MOSFET-транзистора через него течет ток обратного восстановления оппозитного диода, имеющего характеристики его внутреннего диода. Поэтому при расчете для полевого транзистора используется формула Е (мощность динамических потерь транзистора MOSFET с учетом тока обратного восстановления оппозитного диода в режиме «тяжелого» переключения).


Если направление тока не меняется, то он течет через транзистор и оппозитный диод. Когда в схеме есть модуляция скважности, и ток нагрузки изменяет свое направление, транзистор и его антипараллельный диод работают по очереди. В этом случае при расчете потерь необходимо учитывать мощность, рассеивающуюся на открытом диоде.
Результаты расчета, приведенные в таблице 6, однозначно говорят о преимуществах IGBT в полумостовых схемах. Как говорилось выше, можно исключить внутренний диод полевого транзистора с помощью двух быстрых диодов. Можно также ограничить пики тока восстановления с помощью снабберов. Однако при этом схема не только теряет свое изящество, но и заметно ухудшаются ее технические характеристики.

3. О ПРОИЗВОДИТЕЛЯХ
О преимуществах различных фирм, производящих силовые полупроводники, можно говорить бесконечно. Однако скорее всего, Вы выберете не самый лучший элемент, а тот, который проще достать или тот, который Вы хорошо знаете и привыкли к нему. И соотношение цена — качество тоже играет не последнюю роль.
Одно можно сказать уверенно: ведущими разработчиками и производителями MOSFET и IGBT были и остаются International Rectifier, SIEMENS (Infineon), IXYS и Advan-ced Power Technology (APT) . Среди производителей сверхмощных модулей и интеллектуальных силовых модулей можно назвать также FUJI и TOSHIBA .
Для сопоставления приведем таблицы со сравнительными характеристиками некоторых элементов (таблица 7,8 — MOSFET, 9 — IGBT ). Чтобы сравнение было корректным, возьмем транзисторы, имеющие одинаковый корпус, максимальную для данного корпуса мощность и налучшие частотные свойства.
Анализ таблиц показывает, что отдать предпочтение какому-либо из производителей очень сложно. Это еще раз подтверждает, что на рынке силовых компонентов существует жесткая конкуренция, и определяющими могут стать преимущества в стоимости, простоте доставки и технической поддержке. Мы убеждены в том, что по последнему параметру лидирует International Rectifier . Эта фирма появилась на нашем рынке одной их первых и с самого начала своей деятельности делала главный акцент на обеспечение разработчиков технической информацией. С этим утверждением можно не соглашаться, но одно бесспорно: наиболее достоверные SPICE-модели MOSFET и IGBT-транзисторов разработаны специалистами именно этой фирмы. А создание современной техники без математического моделирования невозможно. И в этом мы абсолютно уверены.